什麼是故障分析?
故障分析──也稱為故障調查──是一種針對產品失效進行探究的過程,其目的在於找出並消除故障的根本原因。故障分析會著重於導致失效的環境條件、造成故障的具體機制,以及故障發生的位置。
對於電子產品而言,故障分析會先將故障定位到印刷電路板組件 (PCBA) 上的某個區域,接著再深入檢查該元件或電路板上的位置,以找出確切的故障點。
當產品發生故障時
任何產品故障都需要進行調查,以瞭解導致故障的原因。雖然定位故障位置很重要,但使用故障分析的一大目的,是為了防止相同問題再次發生。透過瞭解潛在的故障機制與根本原因,製造商可以採取修正措施,避免相同問題在未來再次發生。實地故障或保固召回對企業而言代價高昂,可能造成巨大的財務損失與品牌聲譽受損。任何在產品後期出現的故障同樣值得關注。
許多產業會在製造或產品支援流程中,將故障分析作為品質控制 (QC) 的一項手段,用來識別潛在故障、釐清客戶通報問題的根本原因,並確保消費者獲得品質良好的產品。經常進行故障分析的產業包括汽車、航太、國防、製造、生醫與消費性產品等領域,但實際上,任何產業都可以透過故障分析流程,找出製造過程或實地使用中出現問題的原因與位置。
電子產品為什麼會發生故障?
電子產品發生故障的原因有很多種。這類故障通常不是電路設計本身的問題,而是源自於材料選用、熱管理、污染或機構設計方面的缺陷。這可能來自於原本未預期會出現的熱負載或機械負載,也可能是雖已納入考量的負載,但實際產生的影響比預期更為不利。在其他情況下,故障可能來自電路板受污染、對材料特性或行為的理解不完全,或是某種程度的腐蝕作用。
在 PCBA 與各個元件層級上,可能導致故障的失效模式與機制有很多種。一些常見的電子元件故障包括:
- 焊線斷裂和剝離
- 分層
- 電容器開裂
- 晶片損壞
- 導通失效
- 焊錫疲勞與過應力
- 鉛斷裂
- 污染引起的電流洩漏
- 電化學遷移
- 導電陽極絲失效
- 電鍍通孔疲勞
- 焊盤坑裂和線路斷裂
故障分析與根本原因分析
故障分析與根本原因分析 (RCA) 常被交替使用,但這兩者其實並不完全相同。RCA 是著重於探討故障為何發生的一種通用問題解決方法。RCA 會評估與故障相關的各種潛在因素,可能涵蓋組織層面的驅動因素、內部溝通、設計慣例、規格不良、產品使用環境、材料科學上的假設,以及其他各種可能的問題。故障分析屬於 RCA 中的一種資料蒐集技術,著重於對失效裝置進行系統性檢查,以找出故障的根本原因,並提供防止問題再次發生的改善對策。以下這些問題構成了完善故障分析的基礎:
- 故障模式是什麼?
- 故障是如何發生的?
- 故障發生的位置在哪裡?
- 故障的機制是什麼?
- 可以採取哪些措施來防止故障再次發生?
有許多物理與化學的故障分析技術可用於直接檢測電子系統中的故障,包括:
- X 光顯微鏡
- 聲學顯微鏡
- 掃描式電子顯微鏡 (SEM)
- 光學顯微鏡
- 能量散佈 X 射線光譜儀 (EDS)
- 超導量子干涉裝置 (SQUID)
- 熱成像
- 機械測試
- 染色剝離分析
- 橫截面分析
常見的 RCA 技巧,如「五個為什麼」法與六標準差,通常會將故障分析作為一種資料蒐集手段,用於 RCA 所導出的故障改善對策。
為何故障分析很重要
產品故障經常登上新聞,並可能帶來嚴重後果,例如電動車或智慧型手機的電池起火。產品故障不僅代價高昂,還會削弱消費者的信心。
故障分析為製造商提供了一種途徑,透過修正措施與持續改善產品,來重建消費者的信心,並滿足其需求。如果產品已在實際使用中發生故障,找出根本原因並解決問題,是確保更多產品能順利上市的關鍵。
但這件事的影響不僅限於製造商本身。在許多產業中,製造商會從多個來源取得零組件,因此透過故障分析方法,能確保這些零組件足夠可靠且值得信賴,適合用於最終產品中。因此,無論屬於哪個產業,故障分析都能確保整體製造供應鏈的穩健性與可靠性。
常見的 RCA 技巧有哪些?
在釐清產品故障的根本原因時,通常會使用以下四種 RCA 技巧:
五個為什麼:這種方法透過探究故障的因果關係來了解其根本原因。它從問題本身開始,接著持續提出一連串「為什麼」的提問,針對產品與其所處環境進行追問,直到找出答案為止。
魚骨圖 (Ishikawa):魚骨圖因其最終呈現出的形狀而得名。這項工具假設對問題環境完全未知,使工程師能夠從其他可能導致故障的因素進行評估,進而縮小根本原因的範圍。
故障樹狀結構分析:故障樹狀結構分析會將系統拆解為各個元件與子系統。透過分析元件或子系統故障與整體系統之間的關聯,來推導出高階系統的故障路徑。這類分析本質上是針對特定區域中的故障位置進行檢查,並評估其對整體系統的影響。
失效模式與效應分析:故障模式效應分析 (FMEA) 是對故障樹狀結構分析的延伸,它會在每個節點上定義可能的失效模式,並判斷這些失效對子系統與整體系統性能的影響。FMEA 會深入調查至元件與子系統層級,並觀察其對整體系統的影響。與故障樹分析相比,FMEA 能提供更細緻的分析 (例如晶片的時序損失),且根據不同產業的需求,有多種規範與版本可供使用。
如何在故障發生前預防問題
雖然傳統的 RCA 技術十分有用,但可靠性物理學與可靠性工程能提供更深入的見解,幫助釐清產品失效的根本原因。這些方法可在產品開發的任何階段運用,作為 RCA 的依據,並在故障發生前預先防範。
可靠性物理學為故障分析增添了更高層次的準確性。採用基於物理的分析方式,有助於加速失效模式與故障機制的評估,並排除不必要或極不可能的故障選項。
透過瞭解故障的物理本質,工程師可以掌握產品內部的機械、熱、化學與電氣應力如何導致故障。在多數情況下,產品故障並非由電氣因素所引起。實際上,大多數的失效模式是來自熱管理不良、材料選擇不當、污染、機械負載 (以及部分電氣因素) 等原因,這些問題可以透過基於可靠性物理的模擬工具加以捕捉,進而在產品尚未製造前就預防其失效。舉例來說,熱循環故障是電子裝置中常見的問題,但可透過故障分析輕鬆加以改善。
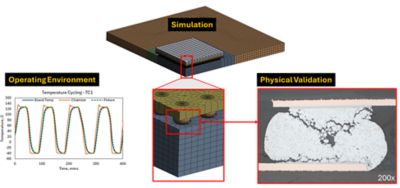
將模擬技術與實體硬體分析結合,有助於加速故障評估流程,並協助工程師深入理解故障的物理本質。
一般的模擬流程可能會從對 PCBA 的設計審查的開始,接著進行有限元素分析 (FEA)。模擬方法可用來評估進料材料、分析機械強度,進而識別失效模式、預測系統可能遭受的故障類型、判定污染容許門檻,並探索能提升系統可靠性的設計變化。
一些實際應用的例子包括:
- 評估灌封材料的理想溫度範圍
- 檢視電池內部可能出現的劣化機制
- 模擬 PCBA 的焊接系統
- 模擬三防塗料對元件可靠性的影響
- 根據原子與分子層級的基本行為,分析蠕變、疲勞與擴散導致的故障模式
案例研究:焊錫疲勞
在 PCBA 中,最常見的失效機制之一就是由熱循環引起的焊錫疲勞。現代 PCBA 是由多種不同材料組成,包括玻璃纖維基板、陶瓷、高分子材料、焊料、矽與銅,這些材料的性質差異極大。在評估焊錫疲勞故障時,最關鍵的材料性質之一是熱膨脹係數 (CTE)。
焊錫常用於電子封裝中,用來將電子元件固定在印刷電路板上,而它通常會連接 CTE 差異極大的材料。由於操作環境變化或元件功耗導致的溫度變化,PCBA 與元件會經歷熱循環,使得各種材料以不同速率膨脹與收縮。這種不一致的膨脹行為會透過焊錫產生蠕變變形來吸收,而隨著時間累積的蠕變應變將導致焊錫產生裂縫,最終造成焊錫球完全斷裂。
對失效樣品進行物理分析──例如電性探針測試、X 光、超音波顯微鏡、光學或 SEM 橫截面觀察,以及染色剝離分析──在確認焊錫裂縫的位置與焊錫疲勞機制方面非常有效。但若要深入探討故障發生的原因,並提出預防再次失效的解決方案,模擬分析就成為不可或缺的工具。透過模擬,分析人員可以納入材料、幾何形狀、環境條件、接合方式以及其他可能促使焊錫疲勞的因素。模擬結果能揭示導致故障的物理機制,並讓企業在實際修正設計前,先行以虛擬方式評估設計或操作條件變更的影響。
Ansys 的故障分析解決方案
無論是在解決故障分析挑戰時採用實體分析與測試,或是透過模擬進行探討,可靠性物理學始終是 Ansys 方法論的核心。我們的可靠度工程服務團隊包括設計卓越性、電子系統設計、封裝與製造等領域的專家組成,能結合物理分析、實測與模擬,應對各種最棘手的故障分析難題。憑藉多年電子設計經驗,團隊總是從非破壞性技術著手,先行辨識故障位置與失效機制。
Ansys 軟體能夠分析各類電子系統,找出在先進技術產品中已存在或可能存在的熱機械問題。模擬是對傳統故障分析物理技術的重要補充,能進一步揭示導致故障的力學行為與材料反應。
Ansys Sherlock™ 電子可靠性預測軟體:用於根據熱機械問題預測產品失效。Sherlock 軟體可以在產品實際運作環境中模擬失效系統的行為,以還原導致失效的過程。這種可靠性分析方式也讓工程師能夠辨識元件、電路板與系統層級的失效機制,進而針對目標應用環境進行更有效的最佳化設計。Sherlock 軟體可在 PCBA 層級進行可靠性預測,並可結合 Ansys Mechanical™ 與 Ansys Icepak® 的模擬結果,將可靠性分析擴展至 PCBA 以外的層面,例如模擬 PCBA 週邊的機構外殼,或設計能降低元件溫度的散熱系統。
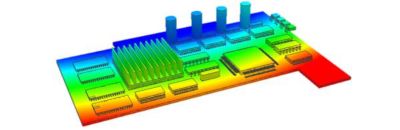
Ansys Sherlock 軟體也可用於模擬機械衝擊對系統的影響
Ansys Mechanical 結構 FEA 軟體:可用來模擬各種最嚴苛的載荷情境,並納入 PCBA 外部的系統元件 (如外殼、結構加強件及其他高階子系統的機械零組件) 進行分析。Mechanical 軟體能用來評估複雜系統組裝下,不同載荷條件下的電路板應變情況。分析結果不僅可用來識別過應力導致的失效,還能匯入至 Sherlock 軟體,進一步進行元件層級的可靠性預測,特別是在載荷與約束條件複雜的情境下。
Ansys Icepak 電子散熱模擬軟體:提供熱分析功能,可評估在不同散熱方案影響下,PCBA 上各元件的溫度變化。Icepak 的模擬結果可用來識別超出元件溫度額定值的熱區,評估元件降額設計的裕度,或整合至 Sherlock 進行元件層級的可靠性預測。

使用 Ansys Icepak 軟體對電路板進行電熱耦合分析
Ansys 已協助超過 3,000 家客戶找出並改善產品失效的根本原因,並透過模擬工具在問題發生前就提供解決方案。如果您也想成為每年超過 300 家選擇 Ansys 解決技術挑戰的企業之一,歡迎立即聯絡我們的物理專家。
相關資源
讓我們開始吧
如果您面臨工程挑戰,我們的團隊將隨時為您提供協助。憑藉豐富的經驗和對創新的承諾,我們邀請您與我們聯絡。讓我們共同合作,將您的工程障礙轉化為成長和成功的機會。立即與我們聯絡,開始對話。