-
-
학생용 무료 소프트웨어에 액세스하기
차세대 엔지니어에게 힘을 실어주는 Ansys
학생들은 세계적 수준의 시뮬레이션 소프트웨어를 무료로 이용할 수 있습니다.
-
지금 바로 Ansys에 연결하십시오!
미래를 설계하기
시뮬레이션이 다음 혁신을 어떻게 지원할 수 있는지 알아보려면 Ansys와 연결하십시오.
국가
무료 트라이얼
제품 및 서비스
학습하기
회사 정보
Back
제품 및 서비스
RedHawk-SC Electrothermal
Ansys RedHawk-SC Electrothermal은 2.5D/3D 멀티 다이 시스템에 대한 다중물리 전력 무결성, 신호 무결성, 열 무결성, 기계적 응력 시뮬레이션 및 분석을 제공합니다.
3DIC에 대한 다중물리 승인
2.5D/3DIC 시스템용 전기, 열 및 기계 사인오프(Signoff) 솔루션
Ansys RedHawk-SC Electrothermal은 다중물리 시뮬레이션 플랫폼입니다. 전력 무결성, 레이아웃 RLC 추출, 열 프로파일링, 열-기계 응력 및 신호 무결성을 위한 멀티 다이 칩 패키지 및 상호 연결 분석에 완벽한 솔루션을 제공합니다. 클라우드 기반 SeaScape 플랫폼에 통합되어 초기 설계 탐구, 레이아웃 이후 설계 검증, 스택형 다이 시스템의 실리콘 승인 등을 위한 대용량 전열 분석이 가능합니다. 이 제품은 통합 팬아웃 및 실리콘 인터포저 기술에 대한 파운드리 인증을 받았습니다.
-
3DIC 물리 모델 어셈블리

-
3DIC PDN 최적화

-
3DIC 시스템의 정확한 열 모델링

-
과도 상태 열 분석


-
칩 열 모델(CTM) 생성 -
패키지 모델 -
칩 전력 모델(CPM) 생성 -
조기 프로토타입 제작 기능
-
정적/과도 상태 열 분석 -
칩/패키지 -
시스템 전력 무결성 시뮬레이션 -
인터포저 모델 추출
-
RedHawk-SC와 연결 -
3DIC 시스템 어셈블리 -
시스템 신호 무결성 시뮬레이션 -
OptisLang과 연결
비디오 제목
Lorem Ipsum은 1500년대 이후로 업계의 표준 더미 텍스트였으며, 알 수 없는 인쇄기가 글꼴 교정쇄를 가지고 뒤섞어 글꼴 보기책을 만들었습니다. 뿐만 아니라 5세기 동안 존속되었습니다.
5G 네트워크 인프라 설계 가속화
eSilicon은 칩-패키지-시스템 모델링 및 시뮬레이션을 사용하여 5G 시장을 위한 제품을 설계하고 검증합니다.
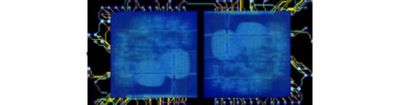
비즈니스 이점
RedHawk-SC Electrothermal은 칩, 보드 및 시스템 수준에서 전기 및 열 분석을 통합하는 포괄적인 다중물리 접근 방식을 통해 오늘날의 복잡한 2.5D/3D IC 패키지의 문제를 해결합니다.
2.5D 인터포저 또는 3D 스태킹 기술을 사용하는 최신 멀티 다이 패키지에는 전력 무결성, 신호 무결성, 열적, 기계적 응력/와피지 등 다양한 물리학에 걸쳐 긴밀하게 결합된 복잡한 통합 시스템이 포함되어 있습니다. 이러한 시스템의 전체 동작을 정확하게 예측할 수 있는 유일한 방법은 여러 도구의 업계 최고의 엔진을 동시 다중물리 솔루션으로 통합하는 통합 분석 환경을 사용하는 것입니다.
RedHawk-SC Electrothermal은 업계 최고의 칩, 보드 및 시스템 수준 도구를 통해 다양한 분야의 Ansys 분석 알고리즘에 대한 통합 액세스를 지원하여 설계 시간과 설계 위험을 줄입니다. 그 범위는 다른 어떤 제품과도 비교할 수 없습니다.
이에 따라 주요 파운드리는 자사의 멀티 다이 패키징 기술에 대한 사인오프 솔루션으로 RedHawk-SC Electrothermal을 인증하게 되었습니다.
높은 용량과 실리콘 관련 정확성을 통해 위험을 낮출 수 있을 뿐 아니라 안전 마진도 줄일 수 있어 전력을 대폭 절감하고 설계 성능을 크게 높일 수 있습니다.
비디오 제목
Lorem Ipsum은 1500년대 이후로 업계의 표준 더미 텍스트였으며, 알 수 없는 인쇄기가 글꼴 교정쇄를 가지고 뒤섞어 글꼴 보기책을 만들었습니다. 뿐만 아니라 5세기 동안 존속되었습니다.
2.5D/3D IC 패키징을 위한 전기, 기계 및 열 다중물리 승인 솔루션
Ansys RedHawk-SC Electrothermal은 멀티 다이 2.5D/3DIC 구조의 전기 및 열 다중물리 상호 작용을 자세히 계산합니다. 여러다른 종류의시스템의 전력, SI 및 응력 방정식을 계산하기 위한 열 및 기계 도구를 포함하여 Ansys RedHawk-SC의 동급 최고 엔진을 사용합니다.
RedHawk-SC Electrothermal은 정확한 전열, 기계적 응력 및 변위 방정식을 계산합니다. RedHawk-SC의 탄력적 컴퓨팅 인프라를 사용하여 최대 10억 개의 인스턴스를 동시에 분석할 수 있습니다. 여기에는 조기 블록 전력 추정과 포괄적인 프로토타입 제작 기능이 포함됩니다. 열 분석은 자동으로 AEDT/Icepak를 실행하여 시스템 수준 분석에서 경계 조건을 가져옵니다.
주요 특징
RedHawk-SC Electrothermal은 파운드리 인증을 받은 2.5D/3D 프로토타입 제작 및 칩/패키지 다중물리 공동 분석용 고용량 전열 솔버입니다.
- 수십억 개의 동시 인스턴스
- 업계 최고의 분석 엔진
- 여러 다른 종류의 입력을 원활하게 처리
- 조기 블록 추정을 통한 프로토타입 분석
- AEDT/Icepak과 통합
- 클라우드 기반 탄력적 컴퓨팅
전체 2.5D/3D 패키지 전력 분배 네트워크의 IR 강하, 전류 밀도 및 일렉트로마이그레이션을 분석합니다. 각 개별 패드에 대해 최대 전류가 보고됩니다. 이러한 분석은 줄 자체 발열을 포함하여 모두 열 인식 분석입니다.
전체 시스템에서 정확한 열 분석을 수행합니다. PCB/시스템 수준의 열 분석을 위해 Ansys Electronics Desktop 및 Ansys Icepak를 실행하면 경계 조건을 자동으로 얻을 수 있습니다.
패키지 상호 연결의 신호 무결성(SI) 효과를 정확히 계산하기 위해 RedHawk-SC Electrothermal은 멀티-다이 패키지의 전체 3D 스택에서 신호와 전원 상호 연결의 RC 기생성을 추출합니다.
Ansys RedHawk-SC Electrothermal에는 Ansys Mechanical의 업계 최고 분석 엔진이 포함되어 있습니다. 패키지의 다양한 요소에서 열 팽창으로 인해 발생하는 기계적 응력과 와피지를 계산합니다.
Ansys RedHawk-SC Electrothermal은 각 블록에서 얻은 전력에 대한 초기 추정치를 바탕으로 패키지의 열 및 전력 무결성 특성에 대한 조기 프로토타입 피드백을 제공할 수 있습니다. 분석을 위해 모든 결과가 대화형 멀티 다이 뷰어에 표시됩니다.
멀티 다이 시스템은 여러 요소로 구성되며, 이는 자체적으로 복잡한 경우가 많습니다. 또한 완전한 최상위 시스템 보기의 분석에서 전체 3D 어셈블리를 배치해야 합니다. RedHawk-SC Electrothermal은 간편한 교환 및 계층 구조 분석을 위해 전력, 열, 신호 무결성 및 ESD 동작을 포착하는 축소 차수 모델의 광범위한 라이브러리를 통해 이러한 기능을 지원합니다.
Ansys RedHawk-SC Electrothermal은 수천 개의 CPU 코어에서 클라우드를 실행할 수 있게 설계된 SeaScape 빅 데이터 분석 플랫폼에 기반을 두고 있으며, 준선형적 확장성과 매우 큰 용량, 코어당 낮은 메모리를 제공합니다.
ANSYS REDHAWK-SC ELECTROTHERMAL RESOURCES & EVENTS
Featured Webinars
On Demand Webinar

Electrothermal Signoff for 2.5D and 3D-IC Systems
This webinar showcases tools, such as Ansys RedHawk-SC Electrothermal, and techniques for modeling multi-die systems, like HBM and PCIE interfaces, with silicon interposers, through-silicon vias (TSVs) and microbumps.
WEBINAR ON DEMAND
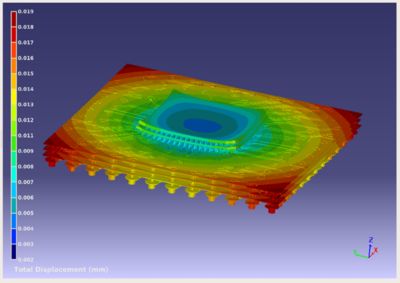
Thermal Integrity Challenges and Solutions of Silicon Interposer Design
In this latest installment of the year-long 3D-IC webinar series, Dr. Lang Lin will discuss the Thermal Integrity issues associated with 3D-IC designs. The presentation will cover thermal hotspots, mechanical stresses induced by thermal issues, and methods for capturing these problems with simulation and virtual prototyping, with a focus on designs that utilize silicon interposers.
누구나 액세스 가능한 Ansys 소프트웨어
Ansys는 장애가 있는 사용자를 포함하여 모든 사용자가 당사의 제품에 액세스할 수 있는 것이 매우 중요하다고 생각합니다. 따라서 미국 접근성 위원회(508조), WCAG( Web Content Accessibility Guidelines) 및 현재 VPAT(Voluntary Product Accessibility Template) 형식에 따른 접근성 요구 사항을 준수하기 위해 노력합니다.
시작하기
엔지니어링 과제에 직면하고 있다면우리 팀이 도와드리겠습니다. 풍부한 경험과 혁신에 대한 헌신을 가지고 있는 우리에게 연락해 주십시오. 협력을 통해 엔지니어링 문제를 성장과 성공의 기회로 바꾸십시오. 지금 문의하기