Ansys RedHawk-SC Electrothermal
Ansys RedHawk-SC电热特性为2.5D/3D多芯片系统提供了多物理功率完整性,信号完整性,热完整性和机械应力仿真及分析。
3DIC的多物理签发
用于2.5D/3DIC系统的电气,散热和机械签发解决方案
Ansys RedHawk-SC电热是一个多物理仿真平台。它提供了一个完整的解决方案,用于分析多芯片封装和互连,以实现功率完整性,布局寄生提取,热分析,热机械应力和信号完整性。集成在云端原生SeaScape平台中,可实现高容量的电热分析,用于早期设计探索,布局后设计验证和堆叠式冲模系统的签发。它通过了集成式扇出和硅插入器技术的代工厂认证。
-
3DIC物理模型装配体

-
3DIC PDN优化

-
3D IC系统的精确热建模

-
瞬态热分析


-
芯片热模型(CTM)生成 -
封装型号 -
芯片功率模型(CPM)系列 -
早期原型功能
-
静态/瞬态热分析 -
芯片/封装 -
系统电源完整性模拟 -
插入器模型提取
-
与RedHawk-SC的链接 -
3DIC系统组件 -
系统信号完整性模拟 -
与OptisLang连接
加速 5G 网络基础设施设计
eSilicon使用芯片封装系统建模和仿真来设计和验证面向5G市场的产品。
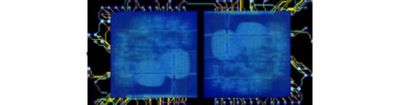
业务优势
RedHawk-SC电热技术通过综合的多物理方法来统一芯片,板级和系统级的电气和热分析,以应对当今复杂的2.5D/3D IC封装的挑战。
具有2.5D插入器或3D堆叠技术的现代多芯片封装组成了复杂的集成系统,这些系统紧密结合在一系列物理环境中,包括功率完整性,信号完整性,热应力和机械应力/翘曲。目前准确预测这些系统整体行为的唯一方法,是使用统一的分析环境,将来自多种工具的市场领先的引擎整合到一个同步的多物理解决方案中。
RedHawk-SC电热技术通过集成访问Ansys分析算法来降低设计时间和设计风险,这些算法来自行业领先的芯片,电路板和系统级工具(跨多个学科)。它的范围是其他任何产品都难以比拟的。
这促使大型芯片制造厂商认可RedHawk-SC电热技术作为其多芯封装技术的签发解决方案。
其高容量和硅相关精度不仅降低了风险,还降低了安全裕度,从而显著降低了功率并提高了设计性能。
用于2.5D/3D IC封装的电气,机械和热多物理签发解决方案
Ansys RedHawk-SC电热解决了多芯2.5D/3DIC结构的电气和热多物理交互的详细问题。它使用Ansys RedHawk-SC的一流引擎,包括热和机械工具来解决异构系统的功率,SI和应力方程。
RedHawk-SC电热能解出准确的电热,机械应力和位移方程。使用RedHawk-SC的弹性计算基础架构,它能够同时分析多达十亿个实例。它包括全面的原型设计功能以及早期模块功率估算。热分析会自动启动AEDT/Icepak,以从系统级分析中获取边界条件。
主要特征
RedHawk-SC电热是一款经过代工厂认证的高容量电热解算器,用于2.5D/3D原型设计和芯片/封装多物理联合分析。
- 数十亿个实例同时出现
- 一流的分析引擎
- 无缝处理异构输入
- 使用早期模块估计进行原型设计
- Sherlock与AEDT Icepak的集成
- 云端原生弹性计算
对整个2.5D/3D封装配电网络进行了IR跌落,电流密度和电迁移分析。报告每个焊盘的峰值电流。这些分析都具有热敏性,包括焦耳自热。
在整个系统上执行准确的热分析。通过启动 Electronics Desktop和Ansys Icepak来自动获得边界条件 ,以便对PCB/系统级别进行热分析。
为了准确计算封装互连中的信号完整性(SI)效应,RedHawk-SC电热将在多芯片封装的整个3D堆栈中提取信号和电源互连的RC寄生效应。
Ansys RedHawk-SC电热包括来自Ansys Mechanical的市场领先的分析引擎 。它可计算封装中各种元素因热膨胀而承受的机械应力和翘曲。
Ansys RedHawk-SC电热可以根据对每个模块所消耗功率的早期估计,提供有关封装的热和电源完整性特性的早期原型反馈。所有结果都显示在交互式多芯片查看器中以供分析。
多芯片系统由多个元素组成,这些元素本身就是复杂的设计。此外,整个3D装配体需要放置在整个顶层系统视图的分析中。RedHawk-SC电热通过大量的降阶模型库来捕获功率,散热,信号完整性和ESD行为,易于紧凑交换和层次分析。
Ansys Totem-SC基于SeaScape大数据分析平台构建,该平台的设计主要用于在数千个CPU内核上执行云计算,具有近似线性的可扩展性和极高的容量,每个内核的内存较低。
ANSYS REDHAWK-SC ELECTROTHERMAL RESOURCES & EVENTS
Featured Webinars
On Demand Webinar

Electrothermal Signoff for 2.5D and 3D-IC Systems
This webinar showcases tools, such as Ansys RedHawk-SC Electrothermal, and techniques for modeling multi-die systems, like HBM and PCIE interfaces, with silicon interposers, through-silicon vias (TSVs) and microbumps.
WEBINAR ON DEMAND
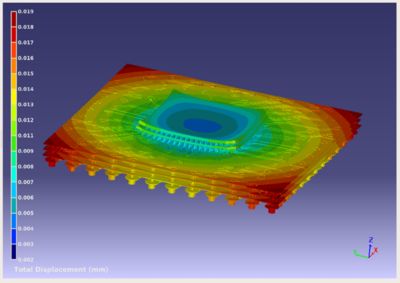
Thermal Integrity Challenges and Solutions of Silicon Interposer Design
In this latest installment of the year-long 3D-IC webinar series, Dr. Lang Lin will discuss the Thermal Integrity issues associated with 3D-IC designs. The presentation will cover thermal hotspots, mechanical stresses induced by thermal issues, and methods for capturing these problems with simulation and virtual prototyping, with a focus on designs that utilize silicon interposers.
可便捷访问的Ansys软件
对于Ansys来说,让所有用户(包括残障人士)都可以访问我们的产品,这一点至关重要。因此,我们努力遵循基于美国访问委员会(第508节),Web内容可访问性指南(WCAG)和自愿产品可访问性模板(VPAT)的当前格式的可访问性要求。
现在就开始行动吧!
如果您面临工程方面的挑战,我们的团队将随时为您提供帮助。我们拥有丰富的经验并秉持创新承诺,期待与您联系。让我们携手合作,将您的工程挑战转化为价值增长和成功的机遇。欢迎立即联系我们进行交流。