Ansys博客
February 29, 2024
什么是共封装光学?
共封装光学(CPO)是一种旨在通过将通信所需的重要元件(即光学及电子元件)更紧密地结合在一起,解决当今数据密集网络中日益增长的带宽密度、通信时延、铜线传输距离以及电源效率挑战的方案。
行业目前采用了光互连输入输出(OIO)和CPO等不同的术语,因而容易造成一些混淆,特别是近封装光学(NPO)经常错误地被视为CPO。需要说明的是,CPO的广泛趋势与OIO相同,即转向基于芯粒的技术,将光学器件集成在3D集成电路(3D-IC)封装中。
可插拔光收发器等
在高分辨率视频流、虚拟现实、物联网(IoT)、高性能计算(HPC)以及人工智能和机器学习(AI/ML)的驱动下,全球网络和数据中心对数据的需求日益增长,因而需要增加带宽、降低延迟和功耗。
光学技术最初只在远距离通信中占主导地位,但随着可插拔光收发器提高了机架之间和机架内部的带宽密度,光学技术也已渗透到较近距离通信的数据中心。虽然这些收发器已从100G发展到400G、800G和1.6T,但在更高速度下,尤其是在AI等数据密集型应用中,其功耗会成为不利因素。此外,“可插拔件”的带宽可扩展性和封装会对6.4T和12.8T等未来容量构成限制。
为了应对这些挑战,该行业正在积极投资CPO和OIO,推出新一代解决方案,以满足新兴应用不断发展和未来大容量网络的需求。联盟、多供应商协议,以及诸如电气与电子工程师协会(IEEE)和光学互联论坛(OIF)等标准机构之间的协作,旨在实现CPO解决方案规范的一致性。
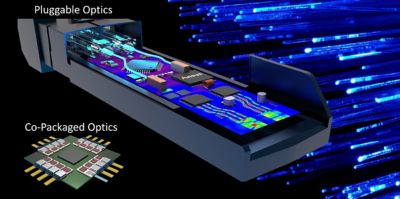
可插拔光学器件与共封装光学器件的对比
获得共封装光学的优势
美国博通(Broadcom)和思科(Cisco)的早期CPO解决方案显示,功耗可节省30-50%,互连功耗约低于1pJ/bit。Ayar Labs展示了5pJ/bit下16Tbps的双向吞吐量。一般来说,CPO提供了几种不同的节能方式:
- 避免铜线损耗:与可插拔光学器件不同,CPO设计无需信号从专用集成电路(ASIC)芯片通过有耗能的铜线穿过电路板到达前面板。相反,CPO设计会将光纤直接引入交换机,在芯片和光学引擎之间实现低损耗近距离通信。
- 更少的数字信号处理器(DSP):在当前速度超过25G/信道的架构中,基于DSP的重定时器已成为可插拔光学器件中的必要组件,以主动分析和补偿信号衰减、失真和定时问题。然而,DSP使整个系统的功耗增加了25-30%。考虑到CPO消除了ASIC和光学器件之间的片外铜线损耗,设计人员可以放心地淘汰一个DSP电平,这不仅可节省功耗,还可降低成本。
- 集成型激光器:对于激光器光源的布置,有两种观点。普遍的方法涉及外部激光器,需要通过光纤传输光信号并将其耦合到CPO中,通常会产生30-50%的光功率损耗。另一种方法是将激光器直接集成到芯片上,与前一种方法相比,只要热管理和激光器的可靠性达到要求,就能提供明显更高的光耦合。
- 高带宽和低延迟:CPO可实现更高的带宽、更低的时延,主要是因为DSP较少,而且取消了长铜线。毕竟,DSP等其它模块以及铜线中的寄生电路都会带来CPO解决方案中不会出现的信号延迟。
应用共封装光学
网络中的CPO:CPO主要被应用于连接数据中心服务器的前端网络。凭借上述高带宽、低时延及高能效优势,CPO是有望为网络应用实现新一代光学以太网技术的方案。
OIO(用于AI/ML的HPC):为了处理AI/ML工作负载,光学行业正在研究一种由OIO支持的新架构,称之为AI后端网络。
在计算方面,传统的孤岛式HPC架构缺乏灵活的资源分配,加上数据传输速率的长期限制,造成了明显的带宽容量瓶颈以及工作负载多样性处理效率低下的问题。随着中央处理单元(CPU)和图形处理单元(GPU)处理速度突飞猛进,现有的I/O基础设施难以跟上步伐,导致处理单元频繁等待数据,效率低下。
随着AI/ML工作负载的需求不断升级,这种困境日益严峻,因而需要一种具有高速、低延迟、无损数据传输和可扩展性等特点的网络结构。而这就是OIO的意义所在,其将彻底改变现状。
不断发展的HPC分解式架构通过将内存、计算和存储分离到由尖端OIO互连的集群中,努力克服了“孤立”模式带来的限制。这一战略性转变可实现动态资源分配,解决传统架构在处理各种数据中心工作负载时的低效率问题。

CPO主要被应用于连接数据中心服务器的前端网络。
了解共封装光学的挑战
- 供应商的束缚:交换机和光学器件由统一厂商提供,意味着超大规模设备可能缺乏灵活性和自由度。因为,一旦已对特定厂商的生态系统进行大规模投资,就很可能在过渡到其他供应商的产品时遇到重重困难。这会限制轻松切换或升级组件的能力,并可能导致依赖性和局限性。
- 可靠性和现场可维护性:可插拔器件高度模块化,可在发生故障时快速更换、可通过任何厂商更换。在CPO中,更换光学器件涉及拔出整个交换机,因此需要一定的专业知识才能完成复杂的相关服务任务。为了应对这一挑战,一些CPO设计将激光器等高风险有源组件分解到更易于现场更换的远程可插拔模块上,而其他机构正在研究可插拔光连接器。
- 热管理:在电气封装中布置光子集成电路(PIC),将增加热串扰的几率。光子裸片中来自热源和激光光源的热功率会影响封装的温度分布图,而电气裸片产生的热量和整个系统的散热机制也会影响PIC的热行为。因此,需要从裸片到系统层面的完整热分析。
- 信号完整性和功率完整性:需要对整个系统进行瞬态仿真,以确保信号和电源的完整性。这不仅需要自洽的电气和光子电路仿真,同时还要考虑来自封装阶段引入的不同类型的电气互连带来的额外寄生效应。
- 可扩展性和带宽密度:因为光纤通常为边缘耦合,CPO和OIO的一个关键指标是沿芯片边缘的带宽密度。最小光纤间距要求会限制给定基板尺寸的光纤数量。鉴于波导和光纤尺寸之间的巨大差异,扇出成了边缘耦合解决方案的固有挑战。想象一下,必须在不增加基板尺寸的情况下,容纳数千条光纤。如果使用V形槽可垂直定向光纤,无需扇出,便可实现边缘耦合解决方案。此外,基于光栅的微透镜耦合与其它创新解决方案也在研究之中。
- 光纤连接:将光信号从光纤阵列高效耦合到封装,是一项极具挑战性的任务。其中有一些注意事项,例如光纤对齐(通过被动或主动对齐方法实现)与倾斜、结构与热管理、可制造性和可维护性等。因此,设计人员需要仔细建模,并优化其光耦合设计。
- 可制造性和可测试性:低成本和高收益,可使设计具有商业可行性。特别是在多厂商供应链中,稳定的质量和有效的测试程序是必不可少的关卡,并将随着需求和投资的增加而不断发展。

在电气封装中布置光子集成电路(PIC),将增加热串扰的几率。
审视相关市场趋势
芯粒的出现:芯粒(Chiplet)实际上是小型单裸片,其可共封装以作为单个芯片运行,从而从片上系统转变为一个封装中的芯片系统。芯粒可能会在CPO被采用的过程中发挥重要作用,甚至能够加速CPO的应用。芯粒方案可在统一封装中混合不同的技术和功能。例如,OIO芯粒可建立在较早的CMOS节点基础之上,ASIC则基于更先进的节点,从而实现更低的成本和更高的良率。
通过3D-IC实现的集成密度:半导体行业正在通过3D-IC技术提高集成密度。尽管目前许多CPO方法都是在低损耗基板上将光学和电气芯片相邻放置,但3D-IC技术的进步可以实现多裸片芯粒CPO,其中,OIO和ASIC通过极低功耗和极高带宽的芯片间通信进行了3D集成。这种集成密度带来了更大、更复杂的设计,因此,对多物理场和电磁(EM)仿真的需求也与日俱增,以分析新出现的物理效应。
线性驱动可插拔光学(LPO):现有的可插拔技术,不会被轻易放弃。与CPO相似,LPO技术通过从可插拔光学器件中移除DSP来实现节能。与传统的可插拔模块相比,CPO中光学及电子元件的紧密布置,实现了几个数量级的微型化。不过,插拔器件本身也可以采用这种微型化技术,以改善其笨重的外形尺寸。
要满足市场期望并赢得最终用户对CPO可行性的信心,就必须展示强大的多供应商业务模式,并显著节省成本和能耗。为了利用行业趋势和技术以加速CPO和OIO的应用,光学界需要解决一些关键部分的缺失问题,如IP模块和光学接口标准等。该过程中,从设计与仿真软件提供商、器件与芯片设计商、系统架构,到封装公司、测试设备提供商和代工厂,供应链中所有参与者的协作必不可少。建立生态系统并非易事,必然需要一定时间。然而,随着AI/ML等大型应用的出现,竞争其实已经拉开帷幕。
如欲了解有关建模共封装光学的更多详情,请访问我们的光学产品系列页面和应用库,其中包含大量示例,例如为光子集成电路的集成微透镜和光栅耦合器建模等。